臭氧作为氧化前体在ALD加工中的应用
随着纳米半导体工艺发展到原子水平,原子层沉积技术变得更有吸引力,并已经看到了一些应用。能够提供活性氧的前驱体是高k栅氧化沉积的关键要求。在众多替代品中,臭氧具有明显的优势。
在过去的十年中,原子层沉积(ALD)(图1)作为一种有前途的先进薄膜沉积技术已经获得了认可。

图1:ALD过程序列:组成ALD循环的典型四步过程。
图1:ALD过程序列:组成ALD循环的典型四步过程。步骤1和2描述了从主要前驱体和衬底材料之间的反应生成的初始膜的生成。步骤3和4描述了所述初始薄膜和反应物前驱体材料之间的反应所产生的所需更终薄膜的生成。
ALD在下一代半导体器件制造中具有许多优于传统CVD的优势。它能够精确控制沉积材料的厚度和成分,在大面积和侵略性的拓扑结构上,通常在先进的器件制造中发现。一般来说,ALD工艺的温度要求比传统CVD低,因此使该技术与较低加工温度的行业趋势相兼容。ALD工艺独特的表面化学性质扩大了薄膜沉积工艺可用前驱体的范围。ALD反应仅发生在衬底表面,这一事实是控制先进介质薄膜三元和四元氧化物体系中薄膜化学计量学的决定因素,使用传统的CVD方法很难或不可能实现这一控制。
更后,在ALD加工中,颗粒和化学污染问题都更容易控制。ALD可用于广泛的薄膜沉积,包括用于先进栅极和电容介质的二元、三元和四元氧化物。ALD也是一种极好的工艺选择,可用于沉积金属,如用于电沉积种子层的Cu和W,用于铜互连屏障的过渡金属氮化物,如TiN和TaN,以及用于FRAM和DRAM电容器电极的贵金属。ALD处理在DRAM电容器结构的形成中特别有效。ALD在DRAM沟槽电容器中介电层的形成中具有独特的优势。这些结构中的纵横比已经变得如此严重,以至于传统的CVD无法提供所需的台阶覆盖。ALD本质上是100%共形的,为这个问题提供了一个独特的解决方案。英飞凌、三星和海力士等公司已经在世界各地的DRAM晶圆厂实施了使用ALD来形成Al2O3电容器电介质的生产工艺。ALD也被广泛应用于开发新型高k栅极氧化物材料以取代SiO2。与SiO2相比,低等效氧化物厚度介电膜的泄漏减少的工艺开发已接近完成。
HfO2, ZrO2和其他高钾材料的工艺,包括三元和季氧化物,如铝酸铪,硅酸盐和氮氧化物。通过ALD形成栅极氧化物和高k介电薄膜需要使用能够在生长的薄膜表面提供活性氧的前驱体。满足这一要求的前体包括O2, H2O2,“OH自由基”,H2O和O3(臭氧)。臭氧在先进介电薄膜ALD中与其它氧化前驱体相比具有明显优势。臭氧的高电化学电位(表1)导致在相对较低的温度下反应速度较快。臭氧是高度挥发性,缩短清洗周期之间的时间。
当ALD工艺使用臭氧而不是水、过氧化氢或氧气等挥发性或活性较低的氧化剂时,这两个因素在工艺吞吐量方面具有显著优势。臭氧分子中氢的缺失导致生长膜中氢和羟基污染的风险降低(氢或羟基仍然可以通过第二前体获得)。
对臭氧ALD与用水ALD形成的Al2O3薄膜的比较研究表明,使用臭氧形成的薄膜中存在较低水平的泄漏电流。羟基污染也被认为会引起诸如退火过程中薄膜分层等问题。以臭氧为氧化前驱体的ALD氧化膜可以在较低的加工温度下制备,具有较高的击穿电压、较低的缺陷密度、良好的粘附性能,因此具有较好的热稳定性。
与表1中列出的其他活性氧化剂相比,臭氧具有进一步的工艺和安全优势,因为它可以在使用点可靠地产生。运输和储存是工艺试剂中的主要污染源,臭氧前体的使用点产生导致ALD工艺和薄膜中的污染物水平极低。图2为臭氧ALD处理的典型设备PFD (Process Flow Diagram)。
目前的
高浓度臭氧发生器,如图2所示,在流量从0.5到5 SLM范围内,可以提供高达20 wt% (300 g/m3)的臭氧浓度。ALD工艺气体开关装置将发生器中产生的臭氧引导到工艺室或通向臭氧洗涤器的旁路。旁路和工艺废水臭氧可以很容易地通过催化或热方法分解回氧气。臭氧是一种安全环保的“绿色”前体,因为它分解的产物只是氧气- 2O3→3O2。在使用地点产生臭氧的能力以及臭氧分解产物的化学性质和毒理性质都可节省大量费用,因为不需要运输、储存和化学处置使用过的氧化剂。
臭氧正被开发为许多ALD薄膜应用的首选氧化前驱体,正是因为上面讨论的优势性质。如前所述,它已经用于生产ALD工艺,在先进的dram中形成Al2O3电容器介电层。臭氧/ALD Al2O3还应用于MEMS结构,如驱动器上的耐磨涂层和磁盘驱动器,其中臭氧/ALD Al2O3被用作记录磁头上的读取器隔离层。臭氧/ALD工艺也被用于生产栅极叠层介质的Al2O3薄膜。臭氧/ALD制备的HfO2和ZrO2 , Ta2O5和La2O3薄膜也在开发中,用于栅极电介质应用。HfO2薄膜具有明显高于氧化铝的介电常数,在这一点上似乎处于生产应用的边缘。金属薄膜也可以通过臭氧/ALD沉积。
首先使用臭氧/ALD沉积CuO,然后使用醇或H2等离子体将氧化铜原位化学还原为单质铜,从而产生铜种子层。ALD加工正在迅速成为先进器件结构上薄膜沉积的首选技术。臭氧作为氧化前体在ALD加工中的应用,其在晶片吞吐量、工艺/薄膜污染、薄膜性能、安全性以及化学处理和处置成本方面的固有优势将成为该市场持续增长的主要因素。



 当前位置:
当前位置: 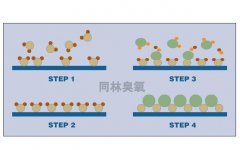
 摘要
摘要


 上一篇:
上一篇: 返回列表
返回列表
